新闻资讯 > 封装
-
ADG749:SC70封装中的2:1多路复用器/SPDT开关

特征●1.8 V至5.5 V单电源●5Ω(最大)导通电阻●电阻平坦度为0.75Ω(典型值)●汽车温度范围:-40°C至+125°C●-3 dB带宽>200 MHz●铁路到铁路运营●6导联SC70封装●快速切换时间--tON=12ns--tOFF=6ns●典型功耗(<0.01μW)●TTL/CMOS兼容应用●电池供电系统●通信系统●取样和保持系统●音频信号路由●视频切换●机械簧片继电器更换一般说明ADG749是一款单片CMOS...
日期:2025-7-1阅读:95 -
LP2985:SOT-23和微SMD封装的微功率150mA低噪声超低压差稳压器

特征■ 超低压差■ 保证150mA输出电流■ 尽可能小的尺寸(SOT-23,微SMD封装)■ 需要最少的外部组件■ 低ESR输出电容稳定■ <1 µA停机时的静态电流■ 所有负载下接地引脚电流低■ 输出电压精度1%(A级)■ 高峰值电流能力■ 宽电源电压范围(最大16V)■ 低变焦:0.3Ω 典型(10Hz至1MHz)■ 过热/过电流保护■ −40°C至+125°C结温范围■ 可提供自定义电压应用■ 便携式电话■ 掌上电脑/笔记本...
日期:2025-6-27阅读:94 -
LP2983:SOT-23封装的微功率150mA稳压器,用于输出电压≤1.2V,设计用于极低ESR输出电容器

特征•工作输入电源电压:2.2 V至16 V•输出电流:150mA•低变焦:0.3Ω 典型(10 Hz至1 MHz)•低ESR输出电容稳定•所有负载下的低接地引脚电流•输出电压精度1%(A级)•高峰值电流能力•宽电源电压范围(最大16V)•过热和过电流保护•-40°C至+125°C结温范围•需要最少的外部组件应用•移动电话•掌上电脑/笔记本电脑•个人数字助理(PDA)•摄像机、个人立体声音响、照相机描述LP2983是一款150mA的固定...
日期:2025-5-23阅读:77 -
LT1617/LT1617-1:采用5引脚SOT-23封装的微功率逆变DC/DC转换器

特征■ 低静态电流:-活动模式下为20µA-关机模式下<1µA■ VIN低至1V时工作■ 低VCESAT开关:250mV,300mA■ 使用小型表面贴装组件■ 高输出电压:高达-34V■ 微型5引脚SOT-23封装应用程序■ LCD偏置■ 手持式计算机■ 备用电池■ 数码相机描述LT®1617/LT1617-1是采用5引脚SOT-23封装的微功率逆变DC/DC转换器。LT1617专为电流限制为350mA、输入电压范围为1.2V至1...
日期:2025-4-25阅读:65 -
KEMET:900系列封装径向引线陶瓷盘式电容器,安全标准认可,X1 400 VAC/Y2 250 VAC(工业级)(工业级)

概述KEMET的900系列封装径向引线陶瓷盘式电容器是专门为干扰抑制交流线路滤波应用而设计的。这些电容器具有国际公认的安全认证,非常适合需要将潜在的破坏性或破坏性线路瞬变和EMI排除在易受影响设备之外的应用。当需要从源头抑制线路干扰时,它们也是一种理想的解决方案。C900 系列电容器采用 900 封装,具有优越的机械强度和耐环境性能。径向引线设计使电容器易于焊接,并且适用于自动贴片和手动装配。其小巧的外形能够有效节省 PCB 板的空间,...
日期:2025-4-8阅读:56 -
ATT_PO12748QAG:5-30GHz衰减器,GaAs单片微波集成电路,采用SMD无引线封装

主要特点■宽带性能:5-30GHz■25dBm典型输入1dB压缩点(任何衰减)■30dB动态范围■直流偏压:-5V<V1<0V-5V<V2<0V■封装类型:16引脚QFN3x3。描述ATT_PO12748QAG是一款5-30GHz的可变振荡器,专为从军事到商业通信系统的广泛应用而设计。该电路采用MESFET工艺制造,栅极长度为0.7µm,通过基板上的通孔和气桥。它以无铅封装提供。操作原理ATTP_PO12748Q...
日期:2025-4-1阅读:52 -
ADF4193的应用及芯片级封装的PCB设计指南

应用GSM基站的本地振荡器显示了ADF4193与VCO一起用于为GSM1800基站产生LO。对于GSM,REFIN信号可以是13 MHz的任何整数倍,但主要要求是转换速率至少为300 V/μs。所示的5 dBm、104 MHz输入正弦波满足此要求。表9给出了各种GSM/PCS/DCS合成器的推荐参数。环路带宽和PFD频率60kHz环路BW足够窄,可以将PLL相位噪声和杂散衰减到Tx低所需的水平。40 kHz BW是满足GSM900 Rx...
日期:2025-3-31阅读:52 -
AD7894:SO-8封装的5V、14位串行、5ms模数转换器(ADC)

特征●转换时间为5ms的快速14位ADC●8导联SOIC封装●单5V电源操作●高速、易用、串行接口●片上跟踪/保持放大器●输入范围的选择◆AD7894-10为±10 V◆AD7894-3为±2.5 V◆AD7894-2为0 V至±2.5 V●高输入阻抗●低功率:20 mW典型值●12位AD7895引脚兼容升级一般说明AD7894是一个快速的14位模数转换器(ADC),由单个+5 V电源供电,并安装在一个小型8引脚SOIC中。该部件包含一...
日期:2025-3-3阅读:36 -
KEMET:900系列封装径向引线陶瓷圆盘电容器

特点•公认的安全标准(IEC 60384-14)•高达125°C的可靠运行•X1/Y1类•10毫米引线间距•无铅,符合RoHS标准•无卤素•电容范围从10pF到10nF•可用电容公差为±5%、±10%和±20%•高可靠性•预成型(压接)或直引线配置•非极性设备,最大限度地减少安装问题•100%纯哑光镀锡铅饰面,具有出色的可焊性•封装符合易燃性标准UL 94V-0应用典型应用包括:•线对线(X类)过滤•线对地(Y级)滤波•天线耦合•初级和...
日期:2025-2-24阅读:27 -
电光互联的新方式:3D封装技术详解
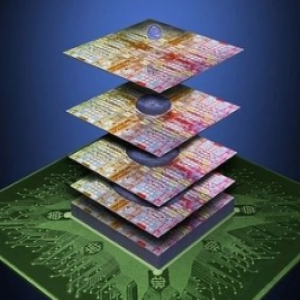
随着人工智能、5G通信、物联网等技术的快速发展,传统芯片的性能提升逐渐逼近物理极限,摩尔定律面临失效。为了突破这一瓶颈,3D封装技术应运而生,成为延续摩尔定律、提升芯片性能的关键技术之一。而在3D封装技术中,电光互联作为一种新兴的互连方式,正展现出巨大的潜力,为未来芯片发展开辟了新的道路。一、3D封装技术:突破传统,立体集成传统的芯片封装采用2D平面结构,所有元器件都排列在同一平面上,通过导线进行连接。这种结构虽然简单易行,但随着芯片功...
日期:2025-2-21阅读:26 -
突破空间限制:3D封装技术如何改变光通信

在数据中心和超级计算机领域,数据传输速度正面临前所未有的挑战。随着人工智能、物联网和5G技术的快速发展,全球数据流量呈现爆炸式增长。传统电互连技术已接近物理极限,无法满足日益增长的数据传输需求。在这个背景下,光通信技术凭借其高带宽、低延迟和抗干扰等优势,成为突破数据传输瓶颈的关键技术。然而,光通信模块的尺寸和集成度限制,制约了其在更广泛场景中的应用。3D封装技术的出现,为光通信技术的发展带来了革命性的突破。一、3D封装技术:突破传统限制...
日期:2025-2-20阅读:25 -
解析Cu Clip封装技术:未来功率芯片的新选择

随着电子行业的迅速发展,功率芯片在各类应用中的重要性愈加突出。从电动汽车到可再生能源,从智能电网到消费电子,功率芯片的性能直接影响系统的效率、可靠性和经济性。因此,先进的封装技术应运而生,以满足不断增长的市场需求。在众多封装技术中,Cu Clip封装技术以其独特的优势,逐渐成为未来功率芯片的一个重要选择。Cu Clip封装技术概述Cu Clip封装技术,顾名思义,是指通过铜夹(Cu Clip)实现芯片与封装基板间的电连接。这种技术采用了...
日期:2025-2-19阅读:23 -
探索晶圆级封装:提升性能与降低成本的秘诀

晶圆级封装(Wafer-Level Packaging, WLP)是一种在晶圆制造完成后直接进行封装的技术,相比传统切割后单独封装芯片的方式,WLP通过批量处理和工艺优化,显著提升了性能并降低了成本。以下是其核心优势及实现机制:一、性能提升的关键1. 更短的互连路径- 电性能优化:WLP直接在晶圆上完成封装,芯片与封装结构的互连距离大幅缩短,降低了信号延迟和功耗,提升了高频性能(如5G、射频芯片)。- 高密度集成:支持更细的布线线宽(微...
日期:2025-2-19阅读:23 -
揭开TGV封装新纪元:微晶玻璃的独特优势
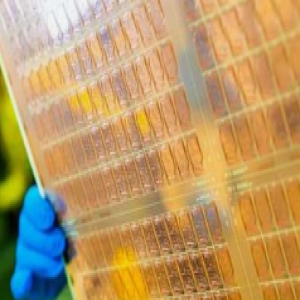
在现代电子与半导体行业中,封装技术的进步不断推动着产品性能和可靠性的提升。作为一种新兴的封装材料,微晶玻璃在TGV(Through Glass Via)封装技术中展现出其独特的优势。随着市场对高性能封装解决方案需求的增加,微晶玻璃的应用前景变得愈加广阔。微晶玻璃的基本特性微晶玻璃是一种由多种成分在高温下熔融后,通过快速冷却和晶体析出过程形成的材料。这种材料不仅在光学特性、机械强度和热稳定性方面表现优异,而且具备良好的化学稳定性和高温性能...
日期:2025-2-18阅读:22 -
突破性能极限:AMD如何利用3.5D封装技术加速AI计算

如今科技发展那叫一个快,人工智能(AI)已经在各行各业里成了不容忽视的重要领域。随着AI计算需求越来越大,以前那种传统的2D封装技术,在性能和效率方面已经有点跟不上趟儿了。就在这时候,AMD公司弄出了挺有创新性的3.5D封装技术,一下子就把计算性能的边界给重新划了划,给AI计算撑了一把强有力的腰。先来说说3.5D封装技术是咋回事儿。这技术啊,就是把好些个芯片模块通过硅中介层(Interposer)给连起来的一种挺先进的封装办法。它最厉害...
日期:2025-2-17阅读:19 -
热管理新突破:芯片3D堆叠封装技术解析
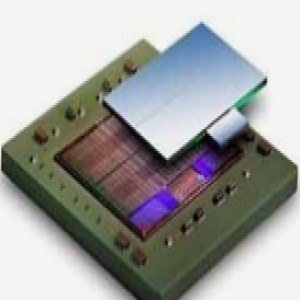
随着电子设备向更小型、更高效的方向发展,芯片的性能要求也日益提高。为了实现更高的计算能力和更快的运算速度,传统的平面封装技术面临着越来越严峻的 thermal challenges(热挑战)。在这一背景下,芯片3D堆叠封装技术应运而生,为解决日益严重的热管理问题提供了突破性的解决方案。1. 3D堆叠封装技术概述3D堆叠封装技术是指将多个集成电路(IC)芯片垂直堆叠在一起,通过垂直互连技术(如微凸点焊接、硅通孔等)进行连接的一种先进封装方...
日期:2025-2-11阅读:14 -
揭秘2.5D封装技术的魅力与关键工艺
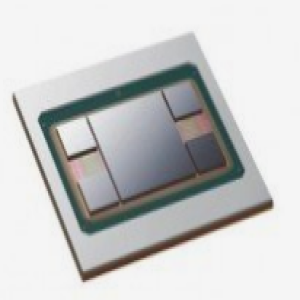
现如今电子产业发展得特别快,在这种情况下,封装技术要是能创新,那对推动半导体行业进步可太重要了。这里面呢,2.5D封装技术因为性能好、灵活性强,散热能力也高效,慢慢就成了高性能计算和数据中心应用方面特别热门的选择。这2.5D封装技术关键就在于它独特的结构设计,还有在制造的时候用的那些先进工艺。先说说2.5D封装的基本概念吧。2.5D封装就是用硅中介层把好多芯片都集成到同一个封装里,这样就能实现高带宽内存和高速信号传输啦。跟传统的2D封装...
日期:2025-2-8阅读:10 -
传统芯片封装的新突破:玻璃材料的应用

在半导体行业迅猛发展的今天,芯片封装作为半导体器件制造的重要环节,一直以来都面临着诸多挑战。随着集成电路的不断微型化、集成度的提高,对封装材料的性能要求也愈加严格。近期,玻璃材料作为一种新型封装材料的应用,正在引领着芯片封装技术的重大突破。无论是在电气性能、热管理还是机械强度等方面,玻璃材料展现出了诸多优势,使其在传统封装材料中脱颖而出。玻璃材料的优越性首先,玻璃材料具有优异的电绝缘性能。与传统的树脂类封装材料相比,玻璃在高频、高速应用...
日期:2025-2-6阅读:7 -
TGV技术揭秘:玻璃基板如何提升封装性能

在现代电子产品的发展里,那可是相当重要啊!您知道啥是TGV技术不?简单说,就是用玻璃基板那薄片儿,在上面开个孔,再填上导电材料弄成通道,这样就能实现电气连接啦,这就是Through Glass Via(TGV)技术。这通道能在基板随便哪个地方摆,电信号传输更高效,还能支持更高的密度呢!您想想,在那智能手机、平板电脑、穿戴设备还有其他高性能电子产品里,有了TGV技术,设计师就能更灵活、更紧凑地设计电路啦!那TGV技术有啥好处呢?首先,高密...
日期:2025-1-21阅读:5 -
芯片封装中的FOPLP封装:应对异构集成的最佳选择
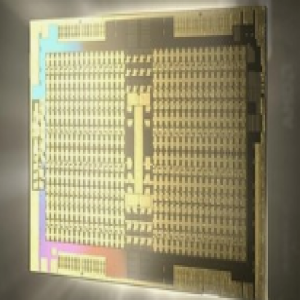
在咱现代这电子产品的设计和制造里头啊,芯片封装技术那可是老重要了!你看这半导体技术发展得贼快,特别是在那智能手机、物联网设备还有高性能计算啥的领域,传统的芯片封装形式慢慢就显出它的不行来了。为了把这问题解决喽,FOPLP(Fan-Out Panel Level Package)封装技术就出来了,就凭它那特别的结构和贼拉好的性能,成了对付异构集成的一把好手。咱再说说这FOPLP封装结构哈。它用的是扇出结构,这么个设计能让芯片的引脚从封装边...
日期:2025-1-20阅读:3
