新闻资讯 > 晶圆
-
台积电系统级晶圆技术将迎重大突破:SoIC、HBM
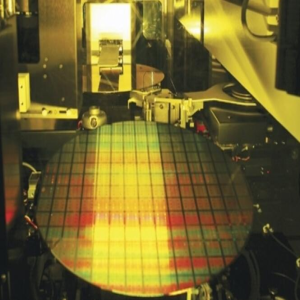
台积电(TSMC)作为全球领先的半导体制造公司,一直在推动封装技术和系统级集成技术的发展。近年来,台积电推出了系统级晶圆技术(System on Integrated Chips, SoIC)和高带宽存储器(High Bandwidth Memory, HBM)等革命性技术,这些技术的发展将是半导体行业的重大突破。SoIC 技术SoIC技术是台积电推动的一项先进3D封装技术。它允许将不同的芯片堆叠和集成在一起,形成具有更高性能、更低功耗...
日期:8小时前阅读:701 -
半导体晶片的测试—晶圆针测制程的确认

半导体晶片的测试是半导体制造过程中至关重要的一环,通过对每个晶片进行测试,可以确保其性能和质量符合设计要求。而晶圆针测制程则是测试中的一个关键步骤,它主要涉及在晶片制程中使用针对晶圆表面的测试装置来进行测试和确认。以下是关于半导体晶片测试和晶圆针测制程的详细介绍:1.半导体晶片的测试:- 测试种类:半导体晶片的测试可分为多种类型,包括初步测试(wafer sort)、功能测试(final test)、电子测试(parametric te...
日期:2024-4-19阅读:692 -
前段制程FEOL—晶圆上的元件制程

前段制程(Front-End-of-Line,FEOL)是集成电路制造中的重要阶段,负责在晶圆表面形成各种元件结构,包括DS1267-010晶体管、电容器等。FEOL是IC制造过程中的关键环节,直接影响着芯片的性能和特性。FEOL制程通常包括以下关键步骤:1. 晶圆清洁与预处理:在FEOL制程开始前,晶圆需要进行严格的清洁和表面处理,以确保后续工艺不受到污染。2. 沉积:在FEOL阶段,会进行各种材料的沉积,例如沉积绝缘层或金属层,用于...
日期:2024-4-3阅读:675 -
晶圆级封装结构的分析

晶圆级封装(Wafer-Level Packaging, WLP)是一种在半导体晶圆制造过程中完成封装的技术,旨在提升集成电路(IC)的性能和可靠性,减小封装尺寸,以及降低成本。本文将对晶圆级封装结构进行全面分析。晶圆级封装的概念与优势晶圆级封装技术是在晶圆加工的最后阶段进行的,即在晶圆切割成单个芯片之前。与传统的封装技术相比,WLP具有多种优势:体积小、重量轻、信号传输距离短、成本低、生产效率高。晶圆级封装的分类晶圆级封装技术主要分为...
日期:2024-4-3阅读:675 -
晶圆清洗:芯片设计与生产中的关键一环

晶圆清洗是芯片设计与生产过程中的重要环节之一,它在整个半导体制造流程中起着至关重要的作用。晶圆清洗通常指的是将经过切割、抛光等前期工序处理后的硅晶圆上的杂质、污染物等进行有效去除,以保证CYP15G0401DXB-BGC芯片的质量和性能。以下将对晶圆清洗在芯片设计与生产中的关键作用进行详细介绍。首先,晶圆清洗可以有效减少制造过程中的污染。在半导体制造过程中,晶圆表面容易附着各种杂质,如灰尘、手指油等,这些杂质会对芯片的性能和稳定性造成不...
日期:2024-3-21阅读:660 -
晶圆的划片工艺分析

晶圆是半导体制造过程中的一种重要材料,它主要由硅等单晶材料制成。晶圆可以看作是一个非常薄而又较大尺寸的圆形基板,在半导体工艺中扮演着承载和衬底功能。晶圆在电子器件制造中被用来制作集成电路芯片、光电器件等。晶圆的制备是半导体工艺中不可或缺的环节,也是影响器件性能的重要因素之一。晶圆的划片工艺是指将大尺寸的晶圆切割成多个小尺寸的EPM9560ARI208-10芯片,用于制作具体的半导体器件。这一步骤通常在晶圆上形成各种器件结构后进行。晶圆的...
日期:2024-3-18阅读:691 -
晶圆测量新利器:光谱共焦传感器优势解析

光谱共焦传感器是一种新型的晶圆测量工具,结合了光谱分析和共焦成像技术。它能够在晶圆表面聚焦激光,收集散射光并将其传输到光谱仪进行分析,从而获取样品的光学特性信息。下面我将详细解析光谱共焦传感器的原理、优势和应用。一、光谱共焦传感器的原理:1. 光谱分析:光谱分析是一种测量物质光学特性的方法,通过分析物质对不同波长或频率的光的吸收、散射或发射来获取物质的信息。光谱分析可以用于确定物质的成分、测量物质的浓度或厚度等。2. 共焦成像:共焦成像...
日期:2024-3-8阅读:732 -
通过X射线光刻在指尖大小的芯片中产生高精度微光学元件的晶圆级制造
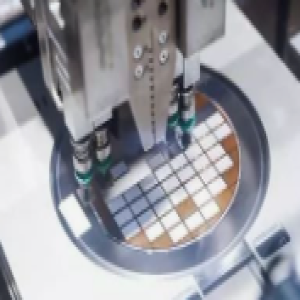
X射线光刻在芯片制造中具有举足轻重的地位。它运用X射线的短波长特性,可以在指射尺寸的芯片中产生高精度的微光学元件。这种精密制造技术的出现,为微电子工业的发展提供了强大的动力。X射线光刻技术首先将一块纯净的硅材料切割成一块块的晶圆,然后在晶圆上形成一层光刻胶。接着,使用X射线照射晶圆,使其暴露部位的光刻胶固化,而未暴露部位的光刻胶则可以被溶解掉。经过一系列的洗涤和烘烤过程,就可以得到精细的结构。在指射尺寸的芯片上,这些结构可以形成高精度的...
日期:2024-2-29阅读:709 -
新型MEMS仿生声敏感芯片设计与晶圆级测试

新型MEMS(微机电系统)仿生声敏感芯片是一种基于仿生学原理设计的声音感应器件,它模拟了人耳的结构和工作原理,能够实现高灵敏度和宽频响的声音检测和分析。在设计和制造过程中,晶圆级测试是一项关键的工艺步骤,用于验证DA14580-01AT2芯片的性能和可靠性。下面将对新型MEMS仿生声敏感芯片的设计和晶圆级测试进行详细介绍。1. 新型MEMS仿生声敏感芯片的设计- 结构设计:新型MEMS仿生声敏感芯片的结构设计是基于仿生学原理和声音感应的...
日期:2024-2-26阅读:771 -
12寸晶圆只能做4个芯片,史上最大图像传感器诞生

在科技日新月异的今天,我们见证了一种新型的、创纪录的图像传感器的诞生。这是一种极其庞大的传感器,以至于在一个12寸的晶圆上仅能制造出四个。这就是目前史上最大的FCA47N60图像传感器。首先,让我们来理解一下晶圆。晶圆是半导体芯片制造过程中的原材料,通常由纯净的硅晶体制成,其直径可以从几厘米到30厘米不等。半导体公司会在这些晶圆上制造出大量的集成电路,然后将它们切割成单独的芯片。因此,一个晶圆的大小直接决定了其上面可以制造的芯片数量。C...
日期:2024-2-21阅读:762 -
半导体行业之晶圆制造与封装概述

晶圆制造和封装是半导体行业中两个重要的生产工艺环节。晶圆制造是指将半导体材料切割成薄片,并在上面进行多次工序的加工,以形成各种微电子器件的过程。而封装则是将制作好的CY2309SC-1H晶圆芯片封装在塑料包装或金属外壳中,以保护芯片并为之提供电气连接。晶圆制造过程包括以下几个主要步骤:1. 单晶片生长:通过化学气相沉积 (CVD) 或物理气相沉积 (PVD) 等方法,在硅石英坩埚中生长出高纯度的单晶硅片。2. 切割:将生长好的单晶硅片切...
日期:2024-1-26阅读:673 -
集成电路封装关键流程:由晶圆到成品芯片

集成电路的制作过程是一项复杂且精细的工作,包括了从晶圆到成品芯片的多个步骤。这一流程涉及到了严格的质量控制和精密的工艺。首先,我们从晶圆开始。晶圆是集成电路生产的基础,通常使用硅或者其他半导体材料制成。晶圆的制作过程包括晶体的生长、切割和抛光。这些步骤需要在高度控制的环境中进行,以确保晶圆的质量和纯度。在晶圆制成后,接下来的步骤就是在其上形成电路图案。这个过程被称为光刻。在光刻过程中,一种叫做光刻胶的光敏材料被涂在晶圆上。然后,通过一种...
日期:2024-1-25阅读:667 -
中科院提出:晶圆级大芯片将使用22 纳米工艺制造——“Zhejiang”

在当今数字化时代,ADS8341E芯片已经成为现代社会的核心技术之一。随着信息技术的不断发展,晶圆级大芯片的需求量也在迅速增长。然而,由于制造难度大、成本高,以及技术瓶颈等原因,晶圆级大芯片的制造一直面临着挑战。中国科学院(CAS)计算技术研究所的研究人员刚刚在《基础研究》杂志上发表了一篇论文,讨论了光刻和小芯片的局限性,并提出了一种他们称之为“大芯片”的架构,该架构模仿了晶圆级Trilogy Systems 在 20 世纪 80 年代...
日期:2024-1-8阅读:662 -
应用在大功率驱动器中的IGBT晶圆
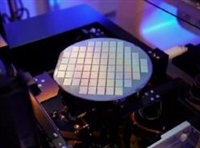
IGBT晶圆是一种广泛应用于CAT24C128WI-GT3大功率驱动器中的半导体器件。IGBT(Insulated Gate Bipolar Transistor,绝缘栅双极型晶体管)是一种高性能功率开关器件,结合了MOSFET(金属氧化物半导体场效应晶体管)的低功耗和BJT(双极型晶体管)的低导通压降特性。IGBT晶圆是一种三端控制器件,结合了MOSFET和BJT的优点。其主要结构由PNP二极管、NPN双极晶体管和MOSFET组成。I...
日期:2023-12-7阅读:686 -
1nm芯片新进展,晶圆代工先进制程竞赛日益激烈!

近年来,1纳米(1nm)芯片成为了半导体行业的热门话题。随着移动互联网、BTS3408G人工智能、物联网等技术的快速发展,对芯片性能的需求也日益增长。1nm芯片作为下一代半导体制程技术的代表,被认为是未来半导体行业的发展方向。目前,全球主要的半导体制造企业正在进行1nm芯片的研发和生产。这些企业包括英特尔、三星、台积电等。他们都在加大对1nm芯片制程的研究力度,希望能够在这一领域取得突破。1nm芯片的制程技术相比于现有的7nm、5nm芯...
日期:2023-12-6阅读:698 -
1nm芯片新进展,晶圆代工先进制程竞赛日益激烈

在半导体行业中,芯片制造技术的进步是推动整个行业发展的关键因素之一。近年来,随着智能手机、物联网、人工智能等领域的快速发展,对芯片性能和功耗的要求也越来越高。为满足市场需求,芯片制造商不断推进制程技术的发展,以提高EPM7032LC44-15芯片性能、降低功耗和成本。其中,1纳米(1nm)芯片制程技术的研发和进展备受关注。1nm芯片制程技术是指制造芯片的最小线宽为1纳米,也就是芯片上各个元件的尺寸达到了1纳米。与目前主流的7nm或10n...
日期:2023-12-5阅读:689 -
SiC晶圆划片工艺:速度提升100倍,芯片增加13%
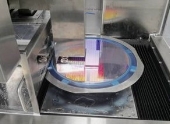
SiC(碳化硅)晶圆划片工艺是制备SiC芯片的关键步骤之一。在该工艺中,SiC晶圆被划分成较小的DRV8800RTYR芯片,以便后续的加工和封装。近年来,研究人员提出了一种新的SiC晶圆划片工艺,其速度提升了100倍,并且成功地增加了芯片的产量。传统的SiC晶圆划片工艺通常使用金刚石切割刀片,这种方法由于硬度较高,切割速度较慢,且易引起晶圆表面的裂纹和缺陷。为了克服这些问题,研究人员采用了新的工艺方法。新的SiC晶圆划片工艺使用了一种高...
日期:2023-11-22阅读:661 -
国产SOI晶圆技术迎来突破性进展,SOI赛道大有可为

国产SOI(Silicon on Insulator)晶圆技术是近年来中国半导体产业的重要发展方向之一。SOI技术通过在晶圆上添加一层绝缘材料,可以提高INA163UA芯片的性能和功耗管理能力。近日,国产300mm RF-SOI晶圆技术取得了突破性进展,这将加快射频产业链的发展,并有望在汽车行业大展拳脚的FD-SOI(Fully Depleted Silicon on Insulator)技术也有望受益。300mm RF-SOI晶圆技术...
日期:2023-10-30阅读:606 -
半导体后端工艺:晶圆级封装工艺

半导体后端工艺是指在晶圆制造完成后,对DRV8838DSGR芯片进行封装和测试的一系列工艺流程。晶圆级封装工艺是其中的一项重要工艺,主要包括晶圆切割、芯片封装和后封装测试等步骤。本文将详细介绍晶圆级封装工艺的流程和关键技术。一、晶圆切割晶圆切割是将整个晶圆切割成多个芯片的过程。晶圆切割主要采用划片机进行,其工作原理是通过钻石切割片在晶圆上划出一条切割线,然后施加力使晶圆断裂,最后通过离心力将切割下来的芯片分离。划片机的主要参数包括划片速...
日期:2023-10-18阅读:603 -
晶圆的另一面:背面供电领域的最新发展研究

背面供电(Backside Powering)是一种新兴的技术,在晶圆制造领域中得到了广泛的关注和研究。与传统的正面供电方式不同,背面供电利用晶圆的背面进行电能传输和供电。这种技术可以提供更高的功率密度、更高的效率和更好的散热性能,为电子设备的发展提供了新的可能。背面供电的基本原理是通过在晶圆背面添加电极和封装材料,实现电能的传输和供电。这种方式可以有效地减少电能在传输过程中的损耗,并提高电能的利用率。此外,背面供电还可以提供更好的散热...
日期:2023-8-31阅读:338
