新闻资讯 > 芯片封装
-
RECOM面向12VDC电源轨推出新一代芯片封装的降压式开关稳压器

RECOM公司是一家专业生产电源模块产品的公司,最近推出了针对12VDC电源轨的新一代芯片封装降压式开关稳压器。这款稳压器采用先进的技术和设计,旨在为工程师和设计师提供高性能、稳定可靠的DSD1791DBR电源解决方案。新一代芯片封装的降压式开关稳压器具有以下特点和优势:1. 高效率:该稳压器采用先进的开关调节技术,能够实现高效的能量转换,减少能量损耗,提高系统整体效率。2. 宽输入电压范围:适用于12VDC电源轨,同时还具有较宽的输入...
日期:2024-4-19阅读:693 -
可靠性与性能并重,长电科技公司推出新一代通信芯片封装方案
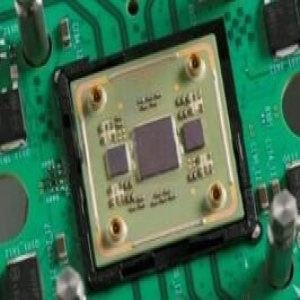
长电科科技公司,作为全球领先的半导体封装测试服务提供商,不断创新技术以满足日益增长的通信市场需求。近日,公司推出了新一代的通信芯片封装方案,旨在为5G和未来通信技术提供更高的性能和可靠性。该封装方案采用了最先进的封装技术,如3D封装、系统级封装(SiP)、嵌入式晶圆级封装(eWLB)等,这些技术能够大幅度提升芯片的性能,同时在尺寸上做到更加紧凑。新方案对于高频信号的传输特别优化,能够支持更宽的带宽和更高的数据传输速率,这对于5G及以后的...
日期:2024-4-15阅读:686 -
苹果探索玻璃基板芯片封装技术助力芯片突破性能瓶颈
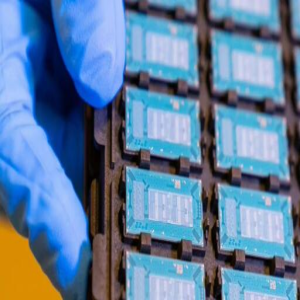
苹果公司一直在寻求技术创新以保持其产品的竞争优势。近年来,随着移动设备对性能和效率的需求日益增长,芯片技术的突破成为了推动行业发展的关键。苹果探索的玻璃基板芯片封装技术便是其中的一项重要进展。传统的芯片封装技术通常使用有机材料作为基板,而玻璃基板封装技术则是一种新兴的技术,它采用玻璃材料作为EP2S60F484C4N芯片封装的支撑基板。相较于有机基板,玻璃基板具有更好的热稳定性和电气特性,能够有效降低芯片操作时的热阻,提高芯片的散热效率...
日期:2024-4-1阅读:672 -
环氧助焊剂助力倒装芯片封装工艺

环氧助焊剂在倒装芯片封装工艺中的应用,是一项革命性的技术进步。这种方法不仅提高了封装的可靠性,还显著改善了生产效率和产品性能。在现代微电子封装领域,倒装芯片(Flip-Chip)技术因其卓越的电气性能和紧凑的封装尺寸而广受欢迎。环氧助焊剂的引入,进一步优化了这一封装技术,下面详细介绍这一进步的意义和实施过程。环氧助焊剂的作用环氧助焊剂主要是基于环氧树脂的一种物质,它能够在焊接过程中提供额外的粘合力,从而增强焊点的机械强度和提高焊接的可靠...
日期:2024-3-15阅读:690 -
半导体芯片封装推拉力测试机合理选择需要考虑哪些方面

半导体芯片是一种集成电路芯片,由半导体材料制成,用于存储、处理和传输电子信息。半导体芯片封装推拉力测试机是用来测试半导体芯片在封装过程中的抗拉和抗压性能的设备。在选择该设备时,需要考虑以下几个方面:1. 测试范围:测试机应当能够覆盖不同尺寸和类型的CD74HCT174E半导体芯片,以满足不同生产需求。2. 测试精度:测试机的测量精度和重复性应当达到行业标准,确保测试结果的准确性。3. 测试速度:快速的测试速度可以提高生产效率,降低成本,...
日期:2024-3-13阅读:693 -
浅谈FCCSP倒装芯片封装工艺

FCCSP(Flip Chip Chip Scale Package)倒装芯片封装工艺是一种尖端的半导体封装技术,它结合了倒装芯片(Flip Chip)技术和芯片级封装(Chip Scale Package, CSP)的优势,旨在提供更小尺寸、更高性能和更好的电气特性的封装解决方案。本文将从FCCSP的基本概念、倒装芯片技术、封装工艺流程、应用领域以及面临的挑战等方面进行浅谈。FCCSP的基本概念FCCSP封装利用倒装技术将FDG332...
日期:2024-3-4阅读:701 -
芯片封装与贴片有什么区别

芯片封装与贴片是电子元器件制造中常见的两种工艺,它们在电子产品中起着重要作用。以下是关于芯片封装与贴片的区别:1. 定义:- 芯片封装:芯片封装是将芯片连接到包含引脚和线路的封装载体上,以便进行安装和连接至电路板上的过程。- 贴片:贴片是指将各种电子元器件贴附到印刷电路板(PCB)等基板上的生产工艺过程。2. 工艺流程:- 芯片封装:芯片封装主要包括将芯片放置在封装底座上、通过焊接等方式连接芯片与封装底座的引脚,最后对整个封装进行密封保...
日期:2024-3-1阅读:741 -
长电科技突破5G毫米波芯片封装模块测试难题

长电科技是一家专注于无线通信芯片封装的公司,最近他们在5G毫米波芯片封装模块的测试过程中遇到了一些难题。本文将详细讨论这些难题,并提出可能的解决方案。作为5G毫米波设备的核心部件——毫米波芯片对封测技术提出很高的要求。目前,越来越多的5G毫米波器件采用AiP天线封装技术来减少系统的尺寸和成本,提高射频性能。长电科技的AiP天线封装技术采用先进的射频设计和优化,确保了信号传输的稳定性和可靠性。5G毫米波技术是新一代无线通信技术,具有高速、...
日期:2024-1-22阅读:697 -
一览半导体芯片封装八大工艺

半导体芯片封装工艺是将制造好的FQD5N50CTM芯片放置在一种支持材料上,并通过封装技术加以保护,同时还提供电气连接和散热等功能的过程。封装工艺是集成电路生产中至关重要的一环,它不仅对芯片的性能、稳定性和可靠性有直接影响,而且决定了芯片的外部引脚布局和大小。封装过程中的关键步骤包括:封装材料制备、芯片粘贴和焊接、引线布局和焊接、密封和测试。首先,封装材料会被加热以使其熔化,并通过注射或浇铸的方式填充到封装模具中,并冷却固化。然后,芯片...
日期:2024-1-17阅读:669 -
什么是MEMS器件封装?MEMS封装与一般芯片封装有什么不同?

MEMS器件封装是微机电系统(Micro-Electro-Mechanical Systems,简称MEMS)技术中至关重要的一环。MEMS是一种将微型机械部件、ADS1232IPWR传感器、执行器和电子元件集成到一个微型芯片上的技术。MEMS器件的封装过程涉及将MEMS芯片与其他电子元件连接,并提供机械支撑和保护,确保其在实际应用中能够正常工作。MEMS封装与传统的半导体芯片封装在多个方面有所不同。首先,由于MEMS器件通常具有可移动...
日期:2024-1-16阅读:652 -
一文读懂芯片封装基(载)板有哪些类型

芯片封装基板是一种用于封装和连接芯片的基础板,也称为载板。它提供了一种将AD7574JN芯片安装在电路板上并提供必要连接的方式。在芯片封装基板上,芯片可以被固定在基板上,并通过焊接或其他连接方式与电路板上的其他元件进行连接。芯片封装基板通常由玻璃纤维增强的环氧树脂基材制成,这种材料具有良好的绝缘性能和机械强度。在制造过程中,基板上会涂上一层铜箔,然后通过化学腐蚀或机械加工的方式将不需要的铜箔去除,以形成电路图案。接下来,通过电镀的方式在...
日期:2024-1-4阅读:681 -
先进芯片封装技术与可穿戴设备之巧妙融合浅析

先进芯片封装技术与可穿戴设备的巧妙融合已经成为当今科技领域的热门话题。随着科技的不断发展和人们对智能化生活的需求不断增加,可穿戴设备已经成为了人们生活中不可或缺的一部分。而ADG333ABRSZ芯片封装技术则是可穿戴设备得以实现的关键技术之一。本文将从芯片封装技术的发展和可穿戴设备的应用领域两个方面进行浅析。一、芯片封装技术的发展芯片封装技术是将芯片封装在一个具有电气连接和机械保护的封装体中,以便于芯片的使用和保护。随着科技的发展,芯片...
日期:2024-1-2阅读:665 -
芯片封装及底部填充(Underfill)技术详解

芯片封装及底部填充(Underfill)技术是在芯片封装过程中使用的一种关键技术,用于提高DS1302ZN芯片的可靠性和机械强度。在本文中,我们将详细介绍芯片封装及底部填充技术的工作原理、应用场景以及一些最新的发展趋势。1、芯片封装的基本概念芯片封装是将芯片封装在一个外部保护壳体中,以提供机械支撑、电气连接和环境保护等功能。芯片封装的主要目的是保护芯片免受机械应力、湿度、温度和化学物质等环境因素的影响,同时提供电气连接和信号传输功能。2...
日期:2023-12-29阅读:732 -
基于玻璃中介板的硅光芯片封装

硅光芯片是光通信系统中的关键组件,其封装技术直接影响着光通信系统的性能与可靠性。传统的硅光芯片封装材料如有机聚合物存在着热膨胀系数与硅芯片不匹配、介质损耗大等问题,限制了硅光芯片的性能与封装密度。而玻璃中介板作为一种优异的封装材料,具有热膨胀系数与硅芯片相匹配、低介质损耗、优良的绝缘性能等优点,成为了硅光芯片封装的重要选择。硅光芯片封装是将硅光芯片封装在适当的载体中,以保护NE555芯片免受外界环境的影响,并提供电气和机械连接。在过去的...
日期:2023-12-20阅读:676 -
什么是芯片封装?倒装芯片(FC)底部填充的原因

芯片封装是将芯片(集成电路)封装在外部包装中的一种技术。封装提供了保护芯片免受环境因素(如湿气、灰尘、机械冲击等)的影响,并为芯片提供电连接、散热和机械支撑等功能。芯片封装的主要目的是提供对CC1101RTKR芯片的物理保护。芯片是由薄片(wafer)切割而来的,因此非常易受损。封装可以将芯片放入一个坚固的外壳中,以保护其免受机械冲击和热应力的影响。封装还可以防止灰尘和湿气进入芯片,从而提高芯片的可靠性和寿命。另外,封装还提供了芯片与外...
日期:2023-12-20阅读:717 -
碳化硅功率半导体多芯片封装技术研究

碳化硅(SiC)功率半导体器件具有高温、高压、高频等特点,被广泛应用于电力电子、新能源、航空航天等领域。然而,现有的封装技术在满足碳化硅器件高性能要求的同时,存在散热、电磁兼容性、尺寸等方面的挑战。为了克服这些问题,研究人员提出了多芯片封装技术。INA3221AIRGVR多芯片封装技术是将多个碳化硅芯片集成到一个封装中,以提高功率密度、减小尺寸、改善散热效果和降低电感等优点。以下是对碳化硅功率半导体多芯片封装技术的研究内容:1、封装材料...
日期:2023-12-20阅读:662 -
芯片封装和存储的区别

芯片封装和存储是半导体行业中两个重要的概念,它们在半导体芯片的制造和应用过程中起到不同的作用。下面将详细介绍芯片封装和存储的定义、功能、制造工艺、应用等方面的区别。一、定义和功能的区别:1、芯片封装:芯片封装是将芯片芯片封装成一个完整的电子器件的过程。芯片封装主要是将裸露的IRFB4227PBF芯片进行保护和连接,以便于外部电路与芯片进行连接。封装过程中主要包括芯片尺寸缩小、引脚外露、引脚保护、引脚连接等步骤,最终形成一个具有特定形状和...
日期:2023-12-19阅读:677 -
探索集成电路芯片封装的未来之路:智能化、自动化与可持续发展

未来集成电路芯片封装的发展趋势主要包括智能化、自动化和可持续发展。这些趋势将推动SN74HC14N芯片封装技术向更高水平发展,满足日益增长的市场需求。首先,智能化是未来集成电路芯片封装的重要发展方向。随着物联网、人工智能、云计算等技术的快速发展,芯片封装需要更高的智能化水平来应对日益复杂的应用场景。智能化封装技术可以实现芯片封装过程的自动化控制和优化,提高生产效率和产品质量。例如,智能封装设备可以根据不同芯片的尺寸、功耗和性能要求,自动...
日期:2023-12-15阅读:774 -
芯片如何安装到主板上?芯片封装工艺流程

芯片安装到主板上是电子设备制造过程中的重要步骤之一。芯片封装是将裸露的芯片封装在一种保护外壳中,以提供电气连接、热管理和机械保护。以下是芯片封装工艺流程的一般步骤:1、芯片准备:AD8606ARZ-REEL7芯片在封装之前需要进行一系列的准备工作,包括测试和分类。测试会检查芯片的功能和质量,而分类会将芯片按照性能和特性进行分组。2、封装设计:根据芯片的尺寸、引脚数量和布局,设计封装的形状和结构。封装设计需要考虑到电气连接、散热和机械强度...
日期:2023-11-8阅读:646 -
微型芯片封装如何选择合适的焊粉尺寸?

在选择TLV3491AIDBVR微型芯片封装的焊粉尺寸时,需要考虑多个因素,包括焊接工艺要求、芯片尺寸和间距、焊点数量、热量传递效果、可靠性等。下面是一些选择合适焊粉尺寸的要点:1、焊接工艺要求:首先,需要了解焊接工艺要求,包括焊接方法(手工焊接、回流焊接等)、焊接温度和时间、焊接设备、焊接材料等。这些要求会对焊粉尺寸的选择产生影响。2、芯片尺寸和间距:考虑芯片的尺寸和间距是选择焊粉尺寸的重要因素。焊粉的尺寸应适合芯片的焊盘尺寸,以确保...
日期:2023-10-27阅读:656
